华为:封装级系统是未来HPC发展趋势
周三(15 日),ICEPT 2021 电子封装技术国际会议正式开幕,华为的 Tonglong Zhang 发表主题演讲表示,封装级系统(package level system)是未来高性能计算(HPC)和网络交换系统的发展趋势。 据 Tongl
周三(15 日),ICEPT 2021 电子封装技术国际会议正式开幕,华为的 Tonglong Zhang 发表主题演讲表示,封装级系统(package level system)是未来高性能计算(HPC)和网络交换系统的发展趋势。
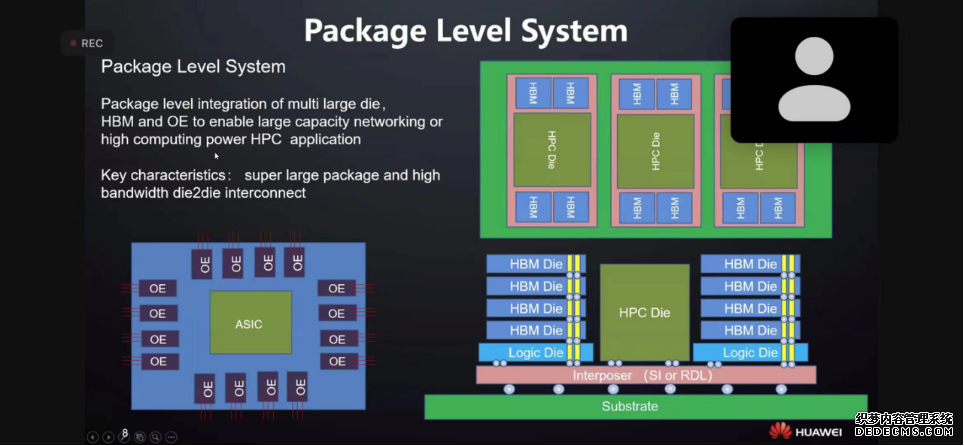
据 Tonglong Zhang 介绍,当前,HPC 芯片有三大发展趋势:1、AI 应用高数据吞吐量带来更高的互联密度需求;2、更多的芯片集成在封装中以提高计算能力,带来超大尺寸封装需求;3、IC 封装间的光数据传输。
在此趋势下,封装级系统技术应运而生,其特点为超大尺寸封装和超宽带的双模互联,具备更高的互联密度更高、更高的数据带宽、较短的互联距离、更低的数据传输能耗与成本。典型的例子包括台积电的 InFO-SoW、英伟达的 ISSCC 2021 超大尺寸封装等。
不过 Tonglong Zhang 也指出,封装级系统仍然面临诸如工艺、可靠性、散热、PI、SI 等挑战。此外,散热和功率传输将是限制 3D 封装的两个关键因素。产业界需要共同努力,应对挑战,推动摩尔定律向前发展。
- 新闻
- 房产
- 汽车
- 娱乐
- 体育




















